Scanning probe microscopy
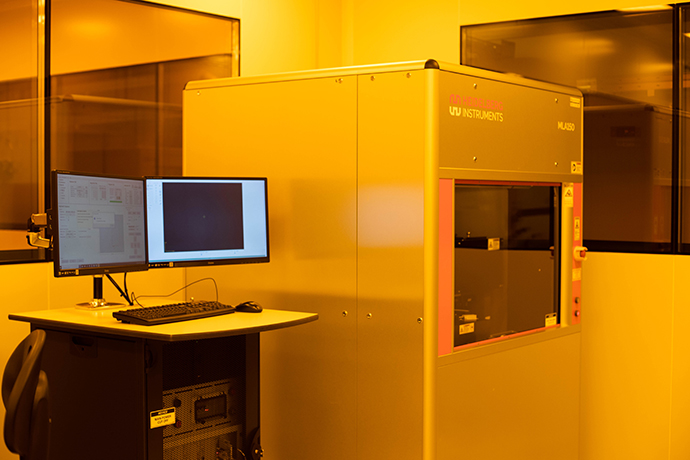
Atomic Force Microscope Park systems NX20
The Park systems NX20 AFM is a large-sample atomic force microscope (AFM) designed for high-resolution imaging, nanomechanical/electrical property measurements, and failure analysis on samples up to 200 mm wafers.
Max Sample size
8” wafer
Configuration
Single-module flexure XY scanner with closed-loop control
Scan range
XY max 100 μm × 100 μm, Z max 15 μm
Standard modes
Non-Contact AFM, Tapping AFM, Contact AFM, Lateral Force Microscopy, nanomechanical AFM (Deformation, Adhesion force, Adhesion energy, Energy dissipation mapping), Nanoidentation
Electrical modes
Conductive AFM, Electrostatic Force Microscopy, Kelvin Probe Force Microscopy, Photoconductive Force Microscopy, Scanning Capacitance Microscopy, Spread Sheet Resistance Microscopy
Optical modes
Torsional Force Microscopy, Piezoresponse Force Microscopy, Scanning Thermal Microscopy, AFM in liquid, Nanolithography, Anodic oxidation.

Atomic Force Microscope Park systems FX40
The Park systems FX40 AFM is an atomic force microscope (AFM) designed to run high resolution measurements of small samples with minimal user intervention using built-in AI and automation.
Max sample size
20 mm x 20 mm
Configuration
Flexure XY scanner with closed-loop control, automatic probe exchange, automatic laser beam alignment
Scan range
XY max 100 μm × 100 μm, Z max 15 μm
Standard modes
Non-Contact AFM, Tapping AFM, Contact AFM, Lateral Force Microscopy, nanomechanical AFM (Deformation, Adhesion force, Adhesion energy, Energy dissipation mapping)
Electrical modes
Conductive AFM, Electrostatic Force Microscopy, Kelvin Probe Force Microscopy
Optional modes
Piezoresponse Force Microscopy, Nanolithography

Stylus profilometer KLA Tencor Alpha-step IQ
The KLA Tencor Alpha-step IQ is a stylus surface profilometer used for step height, thin film, and surface roughness measurements with sub-nanometer vertical resolution.
Max sample size
6” wafer
Vertical Measurement
vertical resolution: ≤ 1 Å (0.1 nm)
vertical range: up to 20um at 0.012A resolution and up to 400um at 0.24A resolution
Lateral (XY) Measurement
Scan length up to 10 mm, lateral resolution: 0.01 µm
Step height repeatability
8A at 20um range and 4000A at 400um range
Measurement Capabilities
Step height / film thickness (angstroms to hundreds of microns), surface roughness (RMS roughness down to <1 nm), waviness / stress features